二次電子の発生
固体に電子を入射したとき、表面から放出される電子が二次電子です。この時、入射電子と同じ 電子が反射してくる場合もあり、これを反射電子といいますが、二次電子と反射電子の区別が つくわけではありませんので、便宜的に、50eVより低いエネルギーを持つ電子を二次電子と 呼んでいます。図1には物質に電子を当てた時に試料から放出される電子のエネルギー分布を 模式的に示しています。この図の横軸はSEMなどの場合はフルスケールが数十キロボルトに なりますので、ログスケールで描くことになっています。二次電子を50eVで区切ったのは、 二次電子がそれだけの大きさのエネルギー幅で放出されるということではなく、便宜的に 二次電子と反射電子の呼び名を50eVで分けたということになります。50eV付近で両電子が 混在しているとすれば、二次電子のシミュレーションだけで得られるエネルギーの分布は もっと狭いエネルギー範囲になってもおかしくないわけです。 ただ、実際にはこの図をSEMのいろいろな試料について測定した例は意外に少なく、この図のほとんどは、 他の分野で測定されたグラフになります。そして、その場合多くは、SEMに比べると低加速電圧での測定され て、二次電子放出係数の最大値δmは、その垂直放射の場合の値δmoに角度依存性F(θ)をかけたものになり ます。図2は、いろいろな試料について二次電子のエネルギー分布を測定し、最大のエネルギーを示す δm = δmo F(θ) 図3のグラフ参照。
電圧Emaxと、その時の二次電子放出係数δmで規格化して一つのグラフにまとめた結果を示して います。この最大値を示す電圧Emは、これもその垂直放射の場合の値Emoに角度依存性F(θ)を かけて求めます。この図に示しますように、少なくともEmaxの二倍付近の電圧まではカーブの 形が物質に依存しないと言うことが Em = Emo F(θ)
この式からわかります。そこで、このカーブをユニバーサルカーブとして式であらわし、 二次電子のシミュレーションで、SiとAuののような値を求める計算を行うときの放出電子を与え るのに、Emaxとδmから計算するという手法がとられます。
δmo = 1.1, 1.4
Em = 250.0, 800.0
SEMで使われる15keVという高い加速電圧で、SiとAuについて二次電子のエネルギーと角度に対する 依存性をであり、F(θ)を測定したのは東京大学の遠藤、井野先生たちで
Surface Science 346(1996)40-48に、Energy and angularF(θ) = 1 / √(cos(θ))
distribution of secondary electrons emitted from Si(111)-7x7, √3x√3-Ag and 5x2-Au surfacesとと置かれます。二次電子放出係数の角度とエネルギー依存性は、
いう論文にまとめられています。この論文によれば、二次電子のエネルギー分布は、図1の ような分布でδ(θ, E) = δm [f*exp^(1-f) ]^a
あり、角度分布もCosθで表され、他の低加速電圧のもとで測定された場合と比べて特に 大きな違いをf = E / Em
生じてはいないようです。
a = 0.62 for f < 1, 0.25 f>=1 二次電子の発生率
二次電子放出係数δmとδmを最大にする入射エネルギーの値Emaxを原子番Z号に対して取ると、 Zに対してn( E) ~√(E) exp(- E/ 2E )
周期的に変化するそうです。また、この二次電子放出係数は仕事関数とともに増加するそう ですが、これはここで Ep = 2.0 eV.
仕事関数が電子の放出過程で表面障壁として作用するばかりでなく、固体中での二次電子の 生成に関係していると言われています。
のようにして求められます。
図4には、このようにして金の円盤試料に垂直に入射した10kVのビームから発生した二次電子 の磁場中での軌道をシミュレーションしたもので、Xy, Xz, YZの3津野面について示しています。 磁場中で電子はサイクロトロン運動をしながら上昇しているものもあり、そうでないものもあります。 磁場の方向に対して大きな角度を持って出てきたビームは、磁場中でサイクロトロン運動をしますが、 ほぼ磁場に平行に出てきた二次電子はそのまま上がっていきます。
 図1. 電子を試料にぶつけた時に放出される電子のエネルギー分布の模式図。 |
 図2.17種の物質に対する二次電子放出カーブ。最大電圧と放出係数で規格化。 西村賢治、大宅薫、光学モデルを用いた2次電子放出のモンテカルロシミュレーション。 沼津工業高等専門学校研究報告第37号、2003年1月。43。 |
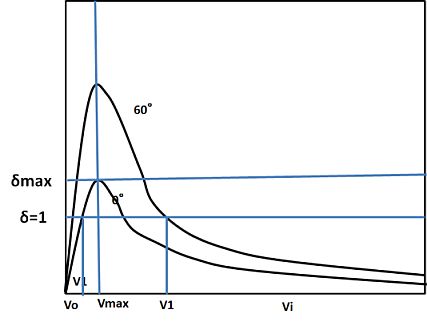 図3. 二次電子のエネルギー分布とその角度依存性の模式図。 |
 図4. 円盤試料に入射した10kVのビームから発生した二次電子の磁場中での電子軌道。 Xy面、XZ面、YZ面のそれぞれから見た軌道を示している。 |
最初のページに戻るコンタクト・質問は、こちら まで♪EOS津野"tsuno6@hotmail.com"作成日 2012/02/02 改定 2018/05/19, 2021/07/25, 2021/10/18 |
2.2. Magnetic Immersion Lens 磁場浸潤型。図2中これは、試料を磁場中に置く方式です。二次電子は磁束に沿ってレンズの中をらせん運動 をしながらポールピースの穴に吸い込まれていきますので、対物レンズの上部に検出器を 置く必要があります。ウィーン型ビームセパレータによって鏡筒の側面に二次電子を導き 、ET検出器で検出します。日立で主に用いられています。対物レンズの下でET検出器に10kV の電圧をかけて二次電子の収集を行っても、レンズの光軸を狂わせることはありませんが、 対物レンズの手前で、検出器に二次電子収集のための電圧をかけてしまいますと、対物 レンズに入射する一次ビームの光軸が狂ってしまいますので、ビームセパレータを用いて、 二次電子を鏡筒の外に導いてから、ET検出器に入れているのです。右の図は基本的には真ん中 の図と同じなのですが、大きな試料を使うために、試料はレンズの外に出し、それでも試料に 磁場がかかるように作られたレンズで、このための色々なレンズ形状がいろいろ提案されています。ウィーン・フィルタを用いたビームセパレーターを図3に示しています。ウィーン・フィルタは 、電場Eと磁場Bの間にE=vB 即ち荷電粒子の速度vを挟んだ関係にある時、ビームは直進します。 このことは、速度vの符号が違えば片方の向きで、このWien条件を満たすように設定すれば、 同じビームを反対向きに走らせたときには、Wien条件は満たされませんので、ビームは直進 出来ず曲がってしまいます。つまり、電子ビームの進む向きによってその進む方向を振り 分けるビームセパレータとして利用することが出来ます。しかも、その時に一方のビームは 直進で、もう一方が曲げられることになるという点が、電場や磁場だけを使って同じことを やろうとしたときに比べた利点となります。 2.3. Retarding field lens。Booster 図2右減速型。加速電圧を試料の直前で低くするタイプ。絶縁体、半導体試料観察の必要性から 低加速化されていきました。対物レンズと試料間でのみ加速電圧を下げることによって、 置全体が低加速化によって性能が劣化することを防いでいます。この図だけからは、このような 使い方ではなく、対物レンズの磁場を試料に漏らして、磁場浸潤型にした場合も考えられます。 二次電子はこの場合も鏡筒内を登っていきますので、一次ビームを通過させるための孔の明いた 半導体インレンズ検出器を光軸上に配置します。この方式は、多くのSEMで実用化されています。3. 磁場浸潤型レンズと スルーザレンズ検出器。1. TEMでは早い時期に磁場浸潤型レンズの使用による分解能の飛躍的向上が図られ、電場レ ンズとの性能の差がはっきりとし、電場レンズを選択した電子顕微鏡メーカーの撤退の原因 にもなりましたが、SEMではConventionalと呼ばれる、試料に磁場のかからないタイプの対物 レンズが使われ続けました。その理由は検出器にありました。2. やがて、TemScanと呼ばれる、TEMにビーム走査機能を付けてSEMやSTEM像を観察できる 装置が現れました。ここでは、SEMの検出器は対物レンズの上部に取り付けられました。 3. 対物レンズの上に検出器を置くタイプはスルーザレンズ方式と呼ばれ、装置もインレンズ SEMと汎用SEMの合体したタイプが作られるようになりました。 4. FEGの登場でインレンズSEMが力を失うと、磁場浸潤型レンズとして、大きな試料を入れ られる方式が模索されました。 5. スルーザレンズ検出器としては、日立のウィーン型ビームセパレータとエバハート・ ソーンリー検出器による方式(図3)と、Zeissによるインレンズ検出器方式が代表的です。 スルーザレンズ方式の検出器の問題点はET検出器に加える電場10kVが一次ビームの軌道を 乱すことにありました。つまり、この乱れが対物レンズの上で起こると、対物レンズの軸が 狂って性能に影響すると言う事情にありました。しかし、レンズの下に検出器が置かれれば、 10kVの電圧を検出器にかけて、二次電子を集めても、レンズの軸には影響せず、像がシフト するだけで済んだわけです。これかがレンズより上にET検出器を置く日立の方式で、光軸上に Wienフィルタを使ったビームセパレータを置いて、検出器を光軸上から離した理由でした。 In-lens方式のSEMは、当時日本電子にいた小池によって開発されました。TEM-SCANと 呼ばれ、STEMとSEMの機能がありました。やがてin-lens-SEMの機能だけが分離して高 分解能SEMとして発売され、通常SEMとのダブル試料室を備えるSEMが発達しましたが、 フィールド・エミッション方式の電子銃FEGの普及によってin-lens-SEMの多くは消滅 しました。しかし、日立では最高分解能のSEMとして残り、収差補正SEMが高加速電圧 を実現できなかったことから、収差補正SEMが出た後も最高分解能を維持し続けました。 TEMでは高加速電圧で収差補正に成功したにも関わらず、SEMで高加速電圧が出来な かった理由は、SEMでは色収差の補正が本質的に重要だったことにあります。TEMでは 最初、色収差の補整が困難であったため、それがいらないSTWEMが使われ、やがて モノクロメーターを使って、エネルギー幅を狭くする方法でTEMでも使えるようになり、 さらに低加速電圧でなら色収差の補正も出来るようになると、低加速で高分解能に 挑戦できるようになっていきました。 4. 大きな試料サイズと磁場浸潤レンズの両立を目指したレンズ開発> 1. シュノーケルレンズ 図4 励磁コイルを小さくして、磁気ヨークの半分がないようなレンズにすると収差係数 を小さくするのに適した磁界分布が実現されます。励磁コイルは強制冷却されて小さい ため、直径10cmのレンズでも1000kVの顕微鏡に取り付けられます[3]。> 2. MulveyのSingle Pole Lens 図5 MulveyはもともとTEMの対物レンズあるいは投影レンズへの応用を意識して考案した ものでしたが、TEMへは使われず、もっぱらSEMへの応用が研究されました。現在は、 SEMへの応用もアンペアターンが過大となること、試料ステージに磁性体が使えない ことなどからSEMにも用いられなくなりましたが、特別の理由から、PEEM装置で商品 化されています。 図5は私が設計した、MulveyのSinglePoleLensです。用途は、ポジトロンSEMと言い まして、普通のSEMに使われるものではなく、使用される電子は極性がマイナスでは なく、プラスを持つ特別の電子に対して用いられるSEMです。 鉄鋼中の空孔で電子と陽電子が対消滅し、γ線を発生します。このγ線を検出する ことで、鉄鋼内の空孔分布を測定します。このSEMの面白い所は、真空中にあるのは 試料までで、対物レンズと検出器は大気中に置かれていることです。検出器を出来る だけ試料に近付けるため、対物レンズの内側磁極に大きな穴を明けて検出器を入れ ています。対物レンズの磁場はまさに試料の下からかかり、その意味ではMulveyの 最初の提案に忠実ですが、反対側の磁極をきちんと設けている点が、Mulveyの提案 から外れていおり、むしろこの後で説明するTangのSide Gap Lensに近いものに なっています。 > 3. TangのSide gap Lens 図6 同じ目的で、ギャップを光軸上に作らず、外向きに作ったレンズです。 いずれも、ギャップが光軸方向を向いておらず、磁場が試料にかかるように工夫 されています。ギャップは狭いですから必要なアンペアターンは大きくはありません。 Mulveyのシングルポールレンズが提案されてから、同じ目的で、アンペア・ターンを 少なくする工夫がいろいろなされました。このレンズがその行き着いた先にあるレンズ だと言えるかもしれません。 作成日 2018/05/19 修正 2019/03/28, 2021/07/13 最初のページ EOS津野"eostsuno@yahoo.co.jp 作成日 2014/05/10 修正 |
最初のページに戻るコンタクト・質問は、こちら まで♪EOS津野"tsuno6@hotmail.com"作成日 2012/02/02 改定 2018/05/19, 2021/07/25, 2021/10/18 |